产品中心PRDUCTS
技术支持RECRUITMENT
0417周五复盘- 这个光通信新细分又跃跃欲试了
2026-04-21 17:10:54
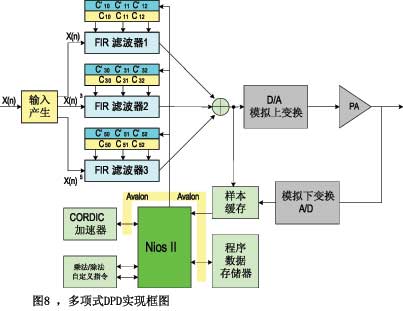
:光通信更上游的电芯片环节——当前25G及以上速率国产化率仅7%,AI驱动光模块速率升级叠加XPO架构普及,TIA/Driver等电芯片价值量将显著重估,这家公司作为国内龙头,已实现25G/100G批量应用,正全面布局400G/800G及硅光组件,国产份额追赶窗口正在打开。
②玻璃基板:台积电CoPoS推进时间线年行业商业化节点临近的大方向未变,玻璃基板热稳定性和超高连接密度优势使其成为AI封装瓶颈的破局方案,SK/LG/三星同步扩产备货,国内产业链处于从验证向量产爬坡的关键阶段。
③半导体:这家半导体设备公司子公司凯世通占据国内离子注入机龙头地位,12英寸晶圆过货量突破1000万片,同时向刻蚀、薄膜沉积横向扩张,35亿元定增锁定“装备+材料+零部件平台化路径,叠加芯片库存周期回暖、晶圆厂扩产与国产化提速三重共振,短期利润承压是转型代价,中期的收入指引给出了明确的增长锚点。
除了传统光模块、光芯片外,机构今年还密集覆盖了新细分-电芯片。机构认为,电芯片(TIA/Driver/CDR等)是决定信号速率与功耗的核心枢纽,其中TIA是在接收端将探测器PD接收到的信号放大,转换成电压信号,Driver是在发射端将电信号转换成激光器驱动的电流信号用于发光。
行情上,优迅股份构建起覆盖光通信收发合一芯片、跨阻放大器芯片(TIA)、限幅放大器芯片(LA)及激光驱动器芯片(LDD)在内的完整产品体系,今日20%涨停。
①电芯片是决定信号速率与功耗的核心枢纽,而非光模块的简单配套,按收入统计,2024年中国厂商在25G速率及以上光通信电芯片领域仅占全球市场7%,高端电芯片仍是产业链“短板”,国产化空间巨大。
②伴随XPO(LPO/NPO/CPO)技术演进,电芯片价值量有望显著提升。由于XPO方案为节省功耗移除了DSP芯片,原本由DSP承担的信号均衡/补偿等工作转移至TIA、Driver等,TIA+Driver类电芯片的绝对价值量及其在系统中的相对价值占比均将得到提升。在LPO等架构中,TIA/Driver需集成DSP的均衡功能,进一步打开从数据中心scale out向scale up场景渗透的更大规模市场。
③优迅股份深耕光通信电芯片二十余年,在10Gbps及以下速率产品细分领域2024年市场占有率位居中国第一、全球第二。单通道25G及4通道100G产品已在数据中心与5G无线传输场景实现批量应用。公司同时掌握深亚微米CMOS及锗硅Bi-CMOS双工艺平台,具备覆盖155Mbps至800Gbps的全速率电芯片设计经验。
④公司正重点推进50G PON接入网电芯片、单波100G/200G数据中心电芯片、400G及以上相干光收发芯片及800G/1.6T硅光组件等方向布局,逐步构建面向超高速数据中心与骨干网的高端产品体系。2025年IPO募集8.09亿元,分别投向下一代接入网及高速数据中心电芯片、车载电芯片、800G及以上光通信电芯片与硅光组件三大方向,为中长期成长空间奠定基础。
一方面,台积电董事长表示,公司正在搭建CoPoS(一种以方形面板取代圆形晶圆的新型先进封装技术)试点产线月开始向研发团队交付设备。
另一方面,行业媒体又表示,由于CoPoS推进难度高于预期,台积电最新规划首批CoPoS封装产品最快要到2030年第4季才能产出,较此前市场预期的2028年量产接棒大幅延后约两年。
①玻璃基板凭借热稳定性、超光滑表面(比有机材料光滑5000倍)和可引导光信号等特性,能够将连接密度提升10倍、降低能耗,是面对AI算力激增带来的散热与封装挑战、突破传统有机基板物理极限的关键方案,同时为芯片间光互联奠定基础,使同等面积内封装更多硅芯片成为可能。
②玻璃基板潜在替代空间达百亿美元。2024年全球封装基板市场规模达126亿美元,Prismark预计2029年为180亿美元,其中ABF载板2023年市场规模为67亿美元,预计2028年103亿美元。
③中美韩等争相布局玻璃基板,自23年9月,英特尔展示玻璃基板样品并发布技术路线图以来,多家接连公布玻璃基板进展(样品、试验线、客户认证等)并制定量产时间表(大多目标在2027-30年量产),中国大陆(京东方、内资封测大厂、沃格光电等)、中国台湾地区(台积电、日月光、群创光电等)、美国(英特尔、AMD等)、韩国(三星、SKC等)等为代表的全球供应链攻坚下,未来几年玻璃基板有望从当前试验线阶段迈向量产。
④2026年有望成为玻璃基板小批量商业化出货的关键节点。 根据半导体产业纵横报道,玻璃基板行业正经历从技术验证向早期量产的关键转折。Yole Group指出,2025年至2030年期间,半导体玻璃晶圆出货量的复合年增长率将超过10%。SK、LG、三星等海外厂商正迅速扩大与材料和工艺供应商的合作,加速量产准备。
⑤玻璃基板TGV技术路线大致已定,部分工程化问题仍有待攻克。制备玻璃基板包括TGV通孔、填孔、RDL布线是三大核心工序,历经多年积累总结,业内当前已形成较高共识,采用激光诱导刻蚀法、电镀等工艺,但因为玻璃材料本身的脆性、绝缘不导电、大尺寸面积结构等因素,仍面临一些工程方面挑战,业内正积极攻坚,探索解决方案。
公司子公司凯世通是国内半导体离子注入设备龙头,同时向薄膜沉积、刻蚀等市场扩展。
在AI浪潮引领下,芯片库存周期、国内晶圆厂扩产周期、海外管制趋严背景下的半导体设备国产化诉求有望实现三重共振。与此同时,今年SEMICON China等展会显示,国内设备厂商在刻蚀、薄膜沉积、先进封装等关键环节的技术能力持续提升,国产化正从“点状突破”走向“系统化能力构建”。
①2025年公司实现营收18.5亿元,同比大幅增长219%。其中铋业务新增收入13.2亿元,受益铋价高位+扩产;离子注入机收入3.5亿元,同比增长44.6%;房地产收入占比已降至10%,标志公司全面转向半导体主业。公司股权激励明确指引26年、27年收入不低于25亿、35亿元,分别对应同比增长约35%和40%。
②离子注入机业务方面,凯世通稳居国产离子注入机领军地位,截至2025年底,12英寸晶圆过货量已突破1000万片,2020年以来累计交付设备50台以上,广泛服务于先进逻辑、先进存储、功率器件及CIS图像传感器等应用领域。2025年新增3家新客户订单,低能大束流离子注入机客户数突破12家,超低温离子注入机客户7家,高能离子注入机客户3家;并成功交付CIS掺杂场景,实现国产CIS离子注入设备的正式验收。
③横向扩张方面,公司旗下嘉芯半导体业务已覆盖刻蚀、薄膜沉积、快速热处理等多类主制程设备,以及尾气处理等支撑制程设备。2026年3月,控股股东先导科技全额认购不超过35.10亿元的定增预案,公司将构建“半导体装备+新材料+零部件的平台化硬科技产业布局,主要投向半导体光学部件、半导体精密零部件和子系统、高端量测装备与生命科学仪器及铋材料业务升级改造四大方向。
④铋材料方面,作为全球稀散金属龙头先导科技集团旗下唯一铋金属深加工及化合物平台,公司受益于国内精铋价格上行及半导体、新能源等下游需求拉动,实现量价齐升。TEC产品已完成送样验证,未来将广泛应用于光通讯、AI、车载、工业仪器及生物医疗等高端领域,“材料—设备”双轮驱动格局日益清晰。


